Submitted:
04 February 2026
Posted:
05 February 2026
You are already at the latest version
Abstract
Keywords:
1. Introduction
1.1. Literature Review Methodology
1.1.1. Search Strategy and Databases
- Primary keywords: “wide bandgap semiconductors”, “silicon carbide power devices”, “gallium nitride HEMT”, “SiC MOSFET”, “GaN power electronics”
- Secondary keywords: “ultrawide bandgap”, “power converter topology”, “electric vehicle inverter”, “DC-DC converter”, “gate driver design”
- Emerging technology keywords: “vertical GaN”, “bidirectional switch”, “gallium oxide power”, “diamond semiconductor”, “aluminum nitride”
- Application keywords: “traction inverter”, “on-board charger”, “solar inverter”, “data center power supply”
1.1.2. Screening and Selection Process
1.1.3. Inclusion and Exclusion Criteria
1.2. Comparison with Existing Review Literature and Added Value
1.2.1. Unique Contributions and Added Value
1.2.2. Research Gap Analysis
2. Material Properties and Comparative Analysis
2.1. Intrinsic Material Characteristics
2.2. Quantitative Performance Metrics: Figures of Merit
3. Emerging UWBG Materials: Development Status and Commercialization
3.1. Beta-Gallium Oxide (-Ga2O3)
3.2. Aluminum Nitride (AlN)
3.3. Diamond
3.4. Cubic Boron Nitride (c-BN)
4. WBG Device Architectures: SiC and GaN
4.1. SiC Device Configurations
4.1.1. SiC MOSFET Structure
4.2. SiC Device Selection Criteria and Loss Models
4.3. GaN Device Configurations
4.3.1. Depletion-Mode (D-Mode) GaN HEMTs
4.3.2. Enhancement-Mode (E-Mode) GaN HEMTs
4.4. GaN Device Selection Criteria and Loss Models
4.5. Vertical GaN Power Devices
4.6. GaN Bidirectional Switches (BDS)
5. Converter Topologies for WBG Devices
5.1. SiC Converter Topologies
5.1.1. Three-Phase Traction Inverter
5.1.2. DC Fast Charging Converter
5.1.3. Grid-Tied Solar Inverter
5.2. GaN Converter Topologies
5.2.1. Buck Converters
5.2.2. Interleaved Buck Converters
5.2.3. Dual Active Bridge Converters
5.2.4. Multilevel DAB Topologies
5.3. GaN Technology Evolution: Vertical GaN and BDS for Converter Topologies
5.3.1. Vertical GaN: Challenging SiC in Medium-Voltage Applications
- Voltage scaling through drift layer thickness rather than lateral area
- No dynamic degradation (no surface traps)
- Avalanche capability similar to SiC MOSFETs
- Reduced chip area for given voltage/current rating
- Limited substrate availability (2–4 inch GaN-on-GaN)
- Higher substrate cost compared to SiC or GaN-on-Si
- Manufacturing maturity gap (TRL 4–5 vs. TRL 8–9 for SiC)
- Projected commercialization: 2026–2028 for 1.2 kV class
5.3.2. Bidirectional GaN Switches: Enabling Single-Stage Power Conversion
- 40–50% size reduction in EV on-board chargers
- Elimination of electrolytic capacitors (improved reliability)
- Inherent bidirectional power flow (V2G capability)
- Higher efficiency through single-stage conversion
- Variable-frequency motor drives
- Solid-state transformers
- Grid frequency conversion
- 50% reduction in on-resistance for bidirectional current path
- Simplified gate drive (two isolated channels vs. four)
- Higher switching frequency capability (>100 kHz vs. 30–50 kHz)
- Reduced PCB complexity and parasitic inductance
5.3.3. Design Guidelines for Technology Selection
5.3.4. Market and Technology Outlook
- 2025: Commercial 650 V GaN BDS devices (Infineon, Navitas); initial vertical GaN sampling at 700–1200 V
- 2026–2027: Production vertical GaN for EV traction; BDS adoption in solar microinverters
- 2028–2030: Vertical GaN challenging SiC in medium-voltage segments; matrix converters becoming mainstream
- 2030+: Potential vertical GaN extension to 3.3 kV for grid applications
6. SiC vs. GaN: Comprehensive Comparison
6.1. Topology-Specific Comparison
6.2. Thermal Stability Considerations
6.3. Efficiency and Loss Comparison
6.4. Application-Specific Recommendations
6.5. Gate Driver Requirements
6.5.1. SiC MOSFET Gate Drive Considerations
6.5.2. GaN HEMT Gate Drive Considerations
6.6. Topology-Level Comparison: V-GaN, BDS and SiC
| Topology | SiC MOSFET | Vertical GaN | GaN BDS |
|---|---|---|---|
| Two-level VSI | – | ||
| Three-level NPC/T-type | |||
| Vienna Rectifier | |||
| Totem-pole PFC | |||
| Matrix Converter | – | – | |
| Cycloconverter | – | – | |
| Single-stage AC/DC | – | – | |
| DAB Converter | |||
| = Optimal; = Suitable; – = Not recommended | |||
6.7. Double Pulse Test Circuit for Device Characterization
6.8. Analytical Equations for Switching Transient Validation
6.9. Technology-Specific Switching Characteristics
6.10. Comparative Performance Summary
| Parameter | SiC MOSFET | GaN HEMT | GaN BDS |
|---|---|---|---|
| (J) | 150–300 | 30–80 | 40–100 |
| (J) | 80–150 | 20–50 | 25–60 |
| (ns) | 30–80 | 8–20 | 10–25 |
| (ns) | 40–100 | 10–25 | 12–30 |
| (nC) | 40–120 | 5–15 | 8–20 |
| Max (kHz) | 100–200 | 1000–5000 | 500–2000 |
7. System-Level Dynamic Validation: GaN vs SiC
7.1. Simulation Methodology
7.2. Switching Waveform Analysis
7.3. Performance Metrics Comparison
7.4. Thermal Implications
7.5. Design Implications
- GaN-optimal regime: Applications prioritizing switching frequency (>100 kHz), power density, or gate driver simplicity benefit from GaN’s 17× superior gate-charge FOM and 1.7× faster switching.
- SiC-optimal regime: High-current applications with moderate switching frequencies (<50 kHz) favor SiC’s 38% lower conduction losses and superior thermal margins.
- Crossover frequency: At approximately 100 kHz and 20 A load current, GaN provides 15% lower total losses, with the advantage increasing at higher frequencies.
8. System-Level Implications and Benefits
8.1. Efficiency Improvements and Economic Impact
8.2. Passive Component Reduction
8.3. Key Performance Indicators Comparison
8.4. Hidden Costs of High-Frequency Operation
8.5. SiC System Benefits
9. Application Landscape and Case Studies
9.1. Automotive and Transportation Applications
9.2. Consumer Electronics and Power Delivery
10. Reliability and Practical Constraints
10.1. SiC Technology Challenges
10.2. GaN Technology Challenges
10.2.1. Dynamic On-Resistance
10.2.2. Short Circuit and Overcurrent Protection
10.3. Common Reliability Considerations
10.3.1. Threshold Voltage Instability
10.3.2. Packaging and Thermal Management
11. Conclusions and Future Perspectives
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
Abbreviations
| 2DEG | Two-Dimensional Electron Gas | AlN | Aluminum Nitride | ANPC | Active Neutral Point Clamped |
| BDS | Bidirectional Switch | BFOM | Baliga Figure of Merit | BHFFOM | Baliga High-Frequency FOM |
| BJT | Bipolar Junction Transistor | CAGR | Compound Annual Growth Rate | CAVET | Current Aperture Vertical Electron Trans. |
| c-BN | Cubic Boron Nitride | CCM | Continuous Conduction Mode | CHFFOM | Combined High-Freq. FOM |
| CMTI | Common-Mode Transient Immun. | CSI | Current Source Inverter | CTE | Coeff. of Thermal Expansion |
| CVD | Chemical Vapor Deposition | CZ | Czochralski | DAB | Dual Active Bridge |
| DFN | Dual Flat No-lead | D-mode | Depletion Mode | DOE | Department of Energy |
| DPD | Distributed Polarization Doping | EFG | Edge-defined Film-fed Growth | EMI | Electromagnetic Interference |
| E-mode | Enhancement Mode | ESR | Equivalent Series Resistance | ETRI | Korea Elec. & Telecom. Res. Inst. |
| EV | Electric Vehicle | FET | Field-Effect Transistor | FOM | Figure of Merit |
| FZ | Floating Zone | GaN | Gallium Nitride | h-BN | hexagonal Boron Nitride |
| HEMT | High Electron Mobility Trans. | HERIC | Highly Eff. & Reliable Inv. Concept | HPHT | High-Pressure High-Temp. |
| HVDC | High-Voltage Direct Current | IEDM | Intl. Electron Devices Meeting | IGBT | Insulated-Gate Bipolar Trans. |
| JAXA | Japan Aerospace Expl. Agency | JFET | Junction Field-Effect Trans. | JFOM | Johnson’s Figure of Merit |
| KFOM | Keyes’ Figure of Merit | KPI | Key Performance Indicator | LGA | Land Grid Array |
| MOSFET | Metal-Oxide-Semicond. FET | NIMS | Natl. Inst. for Materials Sci. | NPC | Neutral Point Clamped |
| OBC | On-Board Charger | OEM | Original Equip. Manufacturer | PCB | Printed Circuit Board |
| PFC | Power Factor Correction | PLA | Pulsed Laser Annealing | PRISMA | Pref. Rep. Items for Syst. Rev. |
| PSU | Power Supply Unit | PV | Photovoltaic | PWM | Pulse Width Modulation |
| QFN | Quad Flat No-lead | RF | Radio Frequency | SBD | Schottky Barrier Diode |
| SiC | Silicon Carbide | SMD | Surface Mount Device | TFOM | Thermal Figure of Merit |
| THD | Total Harmonic Distortion | TRL | Technology Readiness Level | UVLO | Under-Voltage Lockout |
| UWBG | Ultrawide-Bandgap | V2G | Vehicle-to-Grid | VFD | Variable Frequency Drive |
| VSI | Voltage Source Inverter | WBG | Wide-Bandgap | ZVS | Zero Voltage Switching |
References
- International Energy Agency. Global Energy Review 2025; Technical report; International Energy Agency: Paris, 2025. [Google Scholar]
- Deng, Z.; Zhu, B.; Davis, S.J.; et al. Global carbon emissions and decarbonization in 2024. Nature Reviews Earth & Environment 2025, 6, 231–233. [Google Scholar] [CrossRef]
- Tsao, J.Y.; et al. Ultrawide-Bandgap Semiconductors: Research Opportunities and Challenges. Advanced Electronic Materials 2018, 4, 1600501. [Google Scholar] [CrossRef]
- Millán, J.; Godignon, P.; Perpiñà, X.; Pérez-Tomás, A.; Rebollo, J. A Survey of Wide Bandgap Power Semiconductor Devices. IEEE Transactions on Power Electronics 2014, 29, 2155–2163. [Google Scholar] [CrossRef]
- Baliga, B.J. Fundamentals of Power Semiconductor Devices; Springer: New York, NY, USA, 2008. [Google Scholar] [CrossRef]
- Vitale, G. Power Converters for Green Hydrogen: State of the Art and Perspectives. Electronics 2024, 13, 4565. [Google Scholar] [CrossRef]
- Guilbert, D.; Vitale, G. Hydrogen as a Clean and Sustainable Energy Vector for Global Transition from Fossil-Based to Zero-Carbon. Clean Technologies 2021, 3, 881–909. [Google Scholar] [CrossRef]
- Buffolo, M.; Favero, D.; Marcuzzi, A.; De Santi, C.; Meneghesso, G.; Zanoni, E.; Meneghini, M. Review and Outlook on GaN and SiC Power Devices: Industrial State-of-the-Art, Applications, and Perspectives. IEEE Transactions on Electron Devices 2024, 71, 1344–1355. [Google Scholar] [CrossRef]
- Vitale, G. Energy Saving by Power Electronics: Towards a New Concept of Renewable Source. Renewable Energy and Power Quality Journal 2016, 4, 160001–160010. [Google Scholar] [CrossRef]
- Infineon Technologies AG. Scaling AI Data Center Power Delivery with Si, SiC, and GaN: Power Supply Units from 3 to 12 kW; Technical report; Infineon Technologies, 2024. [Google Scholar]
- IDTechEx Research. Power Electronics for Electric Vehicles 2025-2035: Technologies, Markets, and Forecasts. IDTechEx, Technical report. 2024. [Google Scholar]
- STMicroelectronics. Fourth Generation STPOWER Silicon Carbide (SiC) MOSFET Technology for Next-Generation EV Traction Inverters. STMicroelectronics, Technical report. 2024. [Google Scholar]
- Page, M.J.; McKenzie, J.E.; Bossuyt, P.M.; Boutron, I.; Hoffmann, T.C.; Mulrow, C.D.; Shamseer, L.; Tetzlaff, J.M.; Akl, E.A.; Brennan, S.E.; et al. The PRISMA 2020 Statement: An Updated Guideline for Reporting Systematic Reviews. BMJ 2021, 372, n71. [Google Scholar] [CrossRef]
- Rafin, S.S.H.; Ahmed, R.; et al. Power Electronics Revolutionized: A Comprehensive Analysis of Emerging Wide and Ultrawide Bandgap Devices. Micromachines 2023, 14, 2045. [Google Scholar] [CrossRef] [PubMed]
- Chow, T.P.; et al. Wide-Bandgap Semiconductors and Power Electronics as Pathways to Carbon Neutrality. Nature Reviews Electrical Engineering 2025, 2, 1–15. [Google Scholar] [CrossRef]
- Kumar, A.; Moradpour, M.; Losito, M.; Franke, W.T.; Ramasamy, S.; Baccoli, R.; Gatto, G. Wide Band Gap Devices and Their Application in Power Electronics. Energies 2022, 15. [Google Scholar] [CrossRef]
- She, X.; Huang, A.Q.; Lucía, O.; Ozpineci, B. Review of Silicon Carbide Power Devices and Their Applications. IEEE Transactions on Industrial Electronics 2017, 64, 8193–8205. [Google Scholar] [CrossRef]
- Musumeci, S.; Barba, V. Gallium Nitride Power Devices in Power Electronics Applications: State of Art and Perspectives. Energies 2023, 16. [Google Scholar] [CrossRef]
- Belguith, M.; Eloued, S.; Kadi, M.; Ben Hadj Slama, J.; Hamouda, M. A Review of Thermal Management Techniques Adopted for High-Power-Density GaN-Based Converters. Chips 2026, 5. [Google Scholar] [CrossRef]
- Qin, Y.; Albano, B.; Spencer, J.; Lundh, J.S.; Wang, B.; Buttay, C.; Tadjer, M.; DiMarino, C.; Zhang, Y. Thermal management and packaging of wide and ultra-wide bandgap power devices: a review and perspective. Journal of Physics D: Applied Physics 2023, 56, 093001. [Google Scholar] [CrossRef]
- Zhou, J.; Zhong, L.; Feng, X.; Zhang, W.; Liu, X.; Zhou, H.; Liu, Z.; Hao, Y.; Zhang, J. Recent Advances in Device-Level Thermal Management Technologies for Wide Bandgap Semiconductor: A Review. IEEE Transactions on Electron Devices 2025, 72, 2769–2782. [Google Scholar] [CrossRef]
- Zhang, B.; Wang, S. A Survey of EMI Research in Power Electronics Systems With Wide-Bandgap Semiconductor Devices. IEEE Journal of Emerging and Selected Topics in Power Electronics 2020, 8, 626–643. [Google Scholar] [CrossRef]
- Donato, N.; Rouger, N.; Pernot, J.; Longobardi, G.; Udrea, F. Diamond power devices: state of the art, modelling, figures of merit and future perspective. Journal of Physics D: Applied Physics 2019, 53, 093001. [Google Scholar] [CrossRef]
- Green, A.J.; Speck, J.; Xing, G.; Moens, P.; Allerstam, F.; Gumaelius, K.; Neyer, T.; Arias-Purdue, A.; Mehrotra, V.; Kuramata, A.; et al. β-Gallium oxide power electronics. APL Materials 2022, 10, 029201. [Google Scholar] [CrossRef]
- Akbar, G.; Di Fatta, A.; Rizzo, G.; Ala, G.; Romano, P.; Imburgia, A. Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability. Physchem 2025, 5. [Google Scholar] [CrossRef]
- Adeloye, I.A.; Bhattacharya, I.; Ezugwu, E.O.; Antony Dhason, M.V. GaN Electric Vehicle Systems—A Comparative Review. Energies 2025, 18. [Google Scholar] [CrossRef]
- Wu, X.; Zhang, L.; You, H.; Zhang, S.; Nikolov, D.; Cui, Q. EMC-Friendly Gate Driver Design in GaN-Based DC-DC Converters for Automotive Electronics: A Review. Electronics 2026, 15, 283. [Google Scholar] [CrossRef]
- Ambacher, O.; et al. Two-Dimensional Electron Gases Induced by Spontaneous and Piezoelectric Polarization Charges. Journal of Applied Physics 1999, 85, 3222–3233. [Google Scholar] [CrossRef]
- Razeeb, K.M.; et al. Present and Future Thermal Interface Materials for Electronic Devices. International Materials Reviews 2018, 63, 1–21. [Google Scholar] [CrossRef]
- Baliga, B.J. Power Semiconductor Device Figure of Merit for High-Frequency Applications. IEEE Electron Device Letters 1989, 10, 455–457. [Google Scholar] [CrossRef]
- Johnson, E.O. Physical Limitations on Frequency and Power Parameters of Transistors. RCA Review 1965, 26, 163–177. [Google Scholar] [CrossRef]
- Keyes, R.W. Figure of Merit for Semiconductors for High-Speed Switches. Proceedings of the IEEE 1972, 60, 225. [Google Scholar] [CrossRef]
- Hudgins, J.L.; Simin, G.S.; Santi, E.; Khan, M.A. An Assessment of Wide Bandgap Semiconductors for Power Devices. IEEE Transactions on Power Electronics 2003, 18, 907–914. [Google Scholar] [CrossRef]
- Baliga, B. Trends in power semiconductor devices. IEEE Transactions on Electron Devices 1996, 43, 1717–1731. [Google Scholar] [CrossRef]
- Qin, Y.; Wang, Z.; Sasaki, K.; Ye, J.; Zhang, Y. Recent progress of Ga2O3 power technology: large-area devices, packaging and applications. Japanese Journal of Applied Physics 2023, 62, SF0801. [Google Scholar] [CrossRef]
- Herath Mudiyanselage, D.; Da, B.; Adivarahan, J.; Wang, D.; He, Z.; Fu, K.; Zhao, Y.; Fu, H. β-Ga2O3-Based Heterostructures and Heterojunctions for Power Electronics: A Review of the Recent Advances. Electronics 2024, 13. [Google Scholar] [CrossRef]
- Wang, L.; Cheng, J.; Qu, K.; Zhu, Q.; Tian, B.; Yang, Z. Aluminum-Nitride-Based Semiconductors: Growth Processes, Ferroelectric Properties, and Performance Enhancements. Inorganics 2025, 13. [Google Scholar] [CrossRef]
- Haque, A.; Taqy, S.; Narayan, J. Recent Progress in Cubic Boron Nitride (c-BN) Fabrication by Pulsed Laser Annealing for Optoelectronic Applications. Journal of Electronic Materials 2024, 53, 4308–4340. [Google Scholar] [CrossRef]
- Zhang, X. Doping and electrical properties of cubic boron nitride thin films: A critical review. Thin Solid Films The 6th International Conference on Technological Advances of Thin Films & Surface Coatings, 2013; 544, pp. 2–12. [Google Scholar] [CrossRef]
- Haque, A.; Narayan, J. Tunable n-Type Conductivity and Transport Properties of Cubic Boron Nitride via Carbon Doping. ACS Applied Electronic Materials 2021, 3, 1359–1367. [Google Scholar] [CrossRef]
- Narayan, J.; Bhaumik, A. Direct Conversion of h-BN into c-BN and Formation of Epitaxial c-BN/Diamond Heterostructures. Journal of Applied Physics 2016, 119, 185302. [Google Scholar] [CrossRef]
- Mullen, J.T.; et al. Electronic Properties of c-BN/Diamond Heterostructures for High-Frequency High-Power Applications. Diamond and Related Materials 2024, 143, 110920. [Google Scholar] [CrossRef]
- Jones, E.A.; Wang, F.F.; Costinett, D. Review of Commercial GaN Power Devices and GaN-Based Converter Design Challenges. IEEE Journal of Emerging and Selected Topics in Power Electronics 2016, 4, 707–719. [Google Scholar] [CrossRef]
- Lidow, A.; Strydom, J.; de Rooij, M.; Reusch, D. GaN Transistors for Efficient Power Conversion; John Wiley & Sons: Hoboken, NJ, USA, 2014. [Google Scholar] [CrossRef]
- Kimoto, T.; Cooper, J.A. Fundamentals of Silicon Carbide Technology; Wiley-IEEE Press: Hoboken, NJ, USA, 2014. [Google Scholar] [CrossRef]
- Nakamura, T.; et al. High Performance SiC Trench Devices with Ultra-Low Ron. In Proceedings of the Proceedings of the IEEE International Electron Devices Meeting (IEDM), 2011; pp. 26.5.1–26.5.3. [Google Scholar] [CrossRef]
- Chen, K.J.; et al. GaN-on-Si Power Technology: Devices and Applications. IEEE Transactions on Electron Devices 2017, 64, 779–795. [Google Scholar] [CrossRef]
- Huang, X.; Li, Q.; Liu, Z.; Lee, F.C. Analytical loss model of high voltage GaN HEMT in cascode configuration. In Proceedings of the 2013 IEEE Energy Conversion Congress and Exposition, 2013; pp. 3587–3594. [Google Scholar] [CrossRef]
- Uemoto, Y.; et al. Gate Injection Transistor (GIT)—A Normally-Off AlGaN/GaN Power Transistor. IEEE Transactions on Electron Devices 2007, 54, 3393–3399. [Google Scholar] [CrossRef]
- Meneghini, M.; Modolo, N.; Nardo, A.; De Santi, C.; Minetto, A.; Sayadi, L.; Koller, C.; Sicre, S.; Prechtl, G.; Meneghesso, G.; et al. Charge Trapping in GaN Power Transistors: Challenges and Perspectives. In Proceedings of the 2021 IEEE BiCMOS and Compound Semiconductor Integrated Circuits and Technology Symposium (BCICTS), 2021; pp. 1–4. [Google Scholar] [CrossRef]
- Shenoy, P.M.; et al. Vertical GaN MOSFET Power Devices. Micromachines 2023, 14, 1937. [Google Scholar] [CrossRef]
- Liu, J.; Xiao, M.; Zhang, R.; Pidaparthi, S.; Cui, H.; Edwards, A.; Craven, M.; Baubutr, L.; Drowley, C.; Zhang, Y. 1.2-kV Vertical GaN Fin-JFETs: High-Temperature Characteristics and Avalanche Capability. IEEE Transactions on Electron Devices 2021, 68, 2025–2032. [Google Scholar] [CrossRef]
- You, S.; Geens, K.; Borga, M.; Liang, H.; Hahn, H.; Fahle, D.; Heuken, M.; Mukherjee, K.; Santi, C.D.; Meneghini, M.; et al. Vertical GaN devices: Process and reliability. Microelectronics Reliability 2021, 126, 114218. [Google Scholar] [CrossRef]
- Biela, J.; Schweizer, M.; Waffler, S.; Kolar, J.W. SiC versus Si—Evaluation of Potentials for Performance Improvement of Inverter and DC–DC Converter Systems by SiC Power Semiconductors. IEEE Transactions on Industrial Electronics 2011, 58, 2872–2882. [Google Scholar] [CrossRef]
- Su, H.; Zhang, L.; Meng, D.; Li, Y.; Han, N.; Xia, Y. Modeling and Evaluation of SiC Inverters for EV Applications. Energies 2022, 15. [Google Scholar] [CrossRef]
- Whitaker, B.; et al. A High-Density, High-Efficiency, Isolated On-Board Vehicle Battery Charger Utilizing SiC Power Devices. IEEE Transactions on Power Electronics 2014, 29, 2606–2617. [Google Scholar] [CrossRef]
- Pudur, R.; Rajak, M.K. A comprehensive review of grid-connected inverter topologies and control strategies (2020–2025). Next Energy 2025, 9, 100433. [Google Scholar] [CrossRef]
- Reusch, D.; Strydom, J. Understanding the Effect of PCB Layout on Circuit Performance in a High-Frequency Gallium-Nitride-Based Point of Load Converter. IEEE Transactions on Power Electronics 2014, 29, 2008–2015. [Google Scholar] [CrossRef]
- Cohen, L.; Bernstein, J.B.; Aharon, I. Gate Driver for High-Frequency Power Converter. Electronics 2025, 14. [Google Scholar] [CrossRef]
- Erickson, R.W.; Maksimović, D. Fundamentals of Power Electronics, 2nd ed.; Springer: Boston, MA, USA, 2001. [Google Scholar] [CrossRef]
- Renuka Varma, P.C.; Kshirsagar, A. Soft Switched Interleaved Buck Converter for High Power Applications. Proceedings of the 2025 IEEE Energy Conversion Congress & Exposition Asia (ECCE-Asia) 2025, 1–5. [Google Scholar] [CrossRef]
- De Doncker, R.; Divan, D.; Kheraluwala, M. A three-phase soft-switched high-power-density DC/DC converter for high-power applications. IEEE Transactions on Industry Applications 1991, 27, 63–73. [Google Scholar] [CrossRef]
- Kheraluwala, M.H.; Gascoigne, R.W.; Divan, D.M.; Baumann, E.D. Performance Characterization of a High-Power Dual Active Bridge DC-DC Converter. IEEE Transactions on Industry Applications 1992, 28, 1294–1301. [Google Scholar] [CrossRef]
- Hurley, W.G.; Wölfle, W.H. Transformers and Inductors for Power Electronics; Wiley: Chichester, UK, 2013. [Google Scholar] [CrossRef]
- Everts, J. Design and Optimization of an Efficient (96.1kW/dm3) Bidirectional Isolated Single-Phase Dual Active Bridge AC-DC Converter. Energies 2016, 9. [Google Scholar] [CrossRef]
- Badawi, N.; Hilt, O.; Behat-Treidel, E.; Böcker, J.; Würfl, J.; Dieckerhoff, S. Investigation of the dynamic on-state resistance of 600V normally-off and normally-on GaN HEMTs. In Proceedings of the 2015 IEEE Energy Conversion Congress and Exposition (ECCE), 2015; pp. 913–919. [Google Scholar] [CrossRef]
- Han, D.; Li, S.; Wu, Y.; Choi, W.; Sarlioglu, B. Comparative Analysis on Conducted CM EMI Emission of Motor Drives: WBG Versus Si Devices. IEEE Transactions on Industrial Electronics 2017, 64, 8353–8363. [Google Scholar] [CrossRef]
- Zahwan, N.S.H.M.; Hasan, K.N.M.; Bin Zakaria, Z.A. Performance Analysis of SiC and GaN-Based Traction Inverter in Electric Vehicle Drive System. In Proceedings of the 2024 IEEE Sustainable Power and Energy Conference (iSPEC), 2024; pp. 681–686. [Google Scholar] [CrossRef]
- Wang, J.; Xu, Z.; Wang, X.; Zhao, Y.; Liu, G.; Tian, R.; Jing, L. Design of Integrated Magnetic Transformer for High Frequency LLC Converter. In Proceedings of the 2020 4th International Conference on HVDC (HVDC), 2020; pp. 986–991. [Google Scholar] [CrossRef]
- Musavi, F.; Eberle, W. Overview of Wireless Power Transfer Technologies for Electric Vehicle Battery Charging. IET Power Electronics 2014, 7, 60–66. [Google Scholar] [CrossRef]
- Lee, H.; Smet, V.; Tummala, R. A Review of SiC Power Module Packaging Technologies: Challenges, Advances, and Emerging Issues. IEEE Journal of Emerging and Selected Topics in Power Electronics 2020, 8, 239–255. [Google Scholar] [CrossRef]
- Er, B.; Bavtar, G.; Kivanc, O.C. Design and Implementation of a High Power Density GaN-Based USB-PD Charger. In Proceedings of the 2025 IEEE 19th International Conference on Compatibility, Power Electronics and Power Engineering (CPE-POWERENG), 2025; pp. 1–5. [Google Scholar] [CrossRef]
- Ciappa, M. Selected Failure Mechanisms of Modern Power Modules. Microelectronics Reliability 2002, 42, 653–667. [Google Scholar] [CrossRef]
- Wang, H.; Blaabjerg, F. Reliability of Capacitors for DC-Link Applications in Power Electronic Converters—An Overview. IEEE Transactions on Industry Applications 2014, 50, 3569–3578. [Google Scholar] [CrossRef]
- Lelis, A.J.; Green, R.; Habersat, D.B.; El, M. Basic Mechanisms of Threshold-Voltage Instability and Implications for Reliability Testing of SiC MOSFETs. IEEE Transactions on Electron Devices 2015, 62, 316–323. [Google Scholar] [CrossRef]
- Zhu, H.; Matioli, E. Accurate Measurement of Dynamic ON-Resistance in GaN Transistors at Steady-State. IEEE Transactions on Power Electronics 2023, 38, 8045–8050. [Google Scholar] [CrossRef]
- Jin, D.; del Alamo, J.A. Mechanisms responsible for dynamic ON-resistance in GaN high-voltage HEMTs. In Proceedings of the 2012 24th International Symposium on Power Semiconductor Devices and ICs, 2012; pp. 333–336. [Google Scholar] [CrossRef]
- Qiu, X.; Zhang, X.; Lu, P.; Wei, S. Research on Low-Inductance Packaging Design and Switching Characteristics of GaN HEMT Half-Bridge Modules for High-Frequency Converters. Proceedings of the 2025 International Conference on Advanced Energy Systems and Power Electronics (AESPE) 2025, 29–33. [Google Scholar] [CrossRef]
| 1 | Technology Readiness Levels (TRL) follow the Horizon 2020 Work Programme definitions (European Commission, 2014–2020): TRL 1–3 (research), TRL 4–6 (development/validation), TRL 7–9 (demonstration/deployment). |






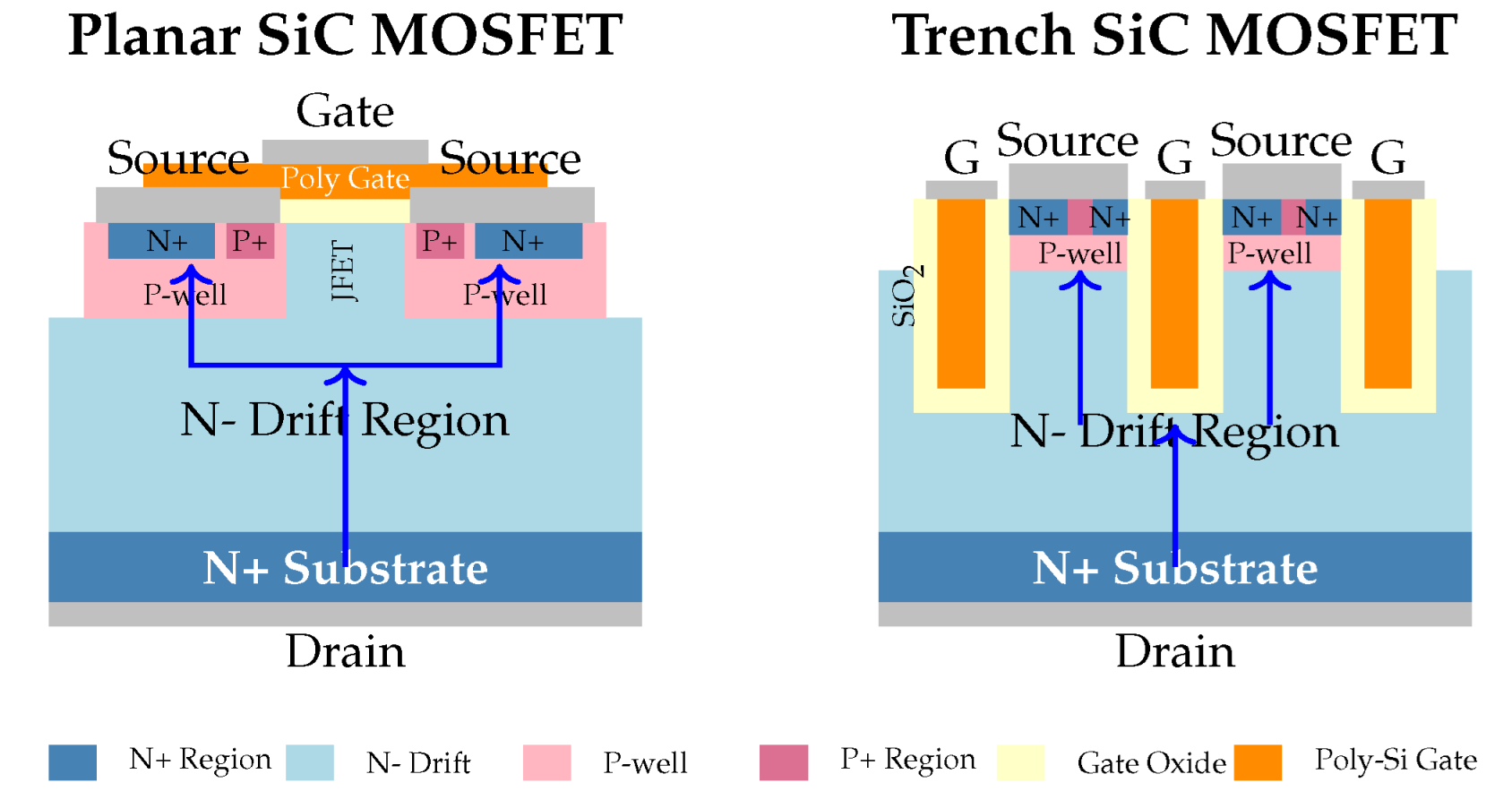
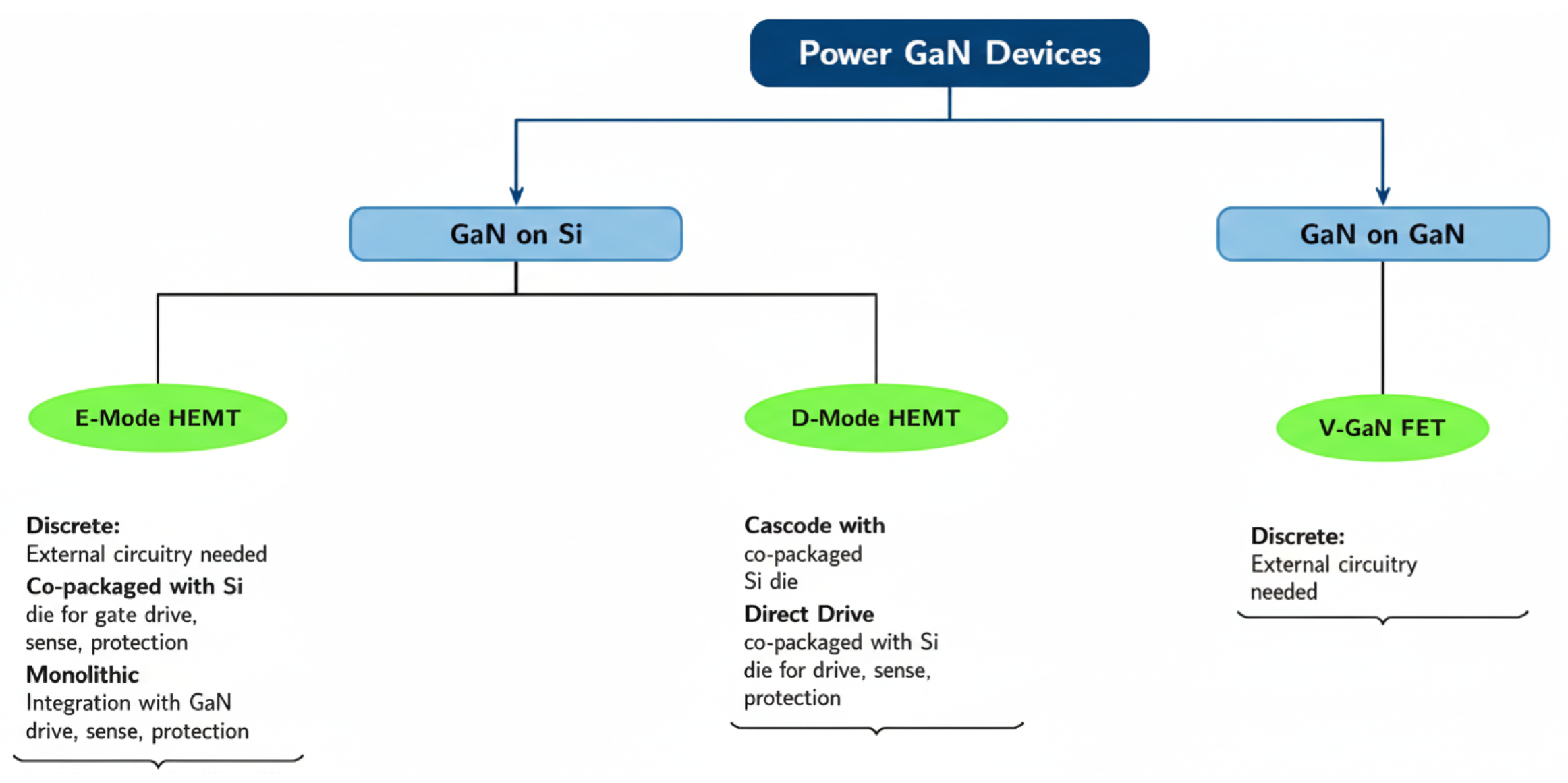
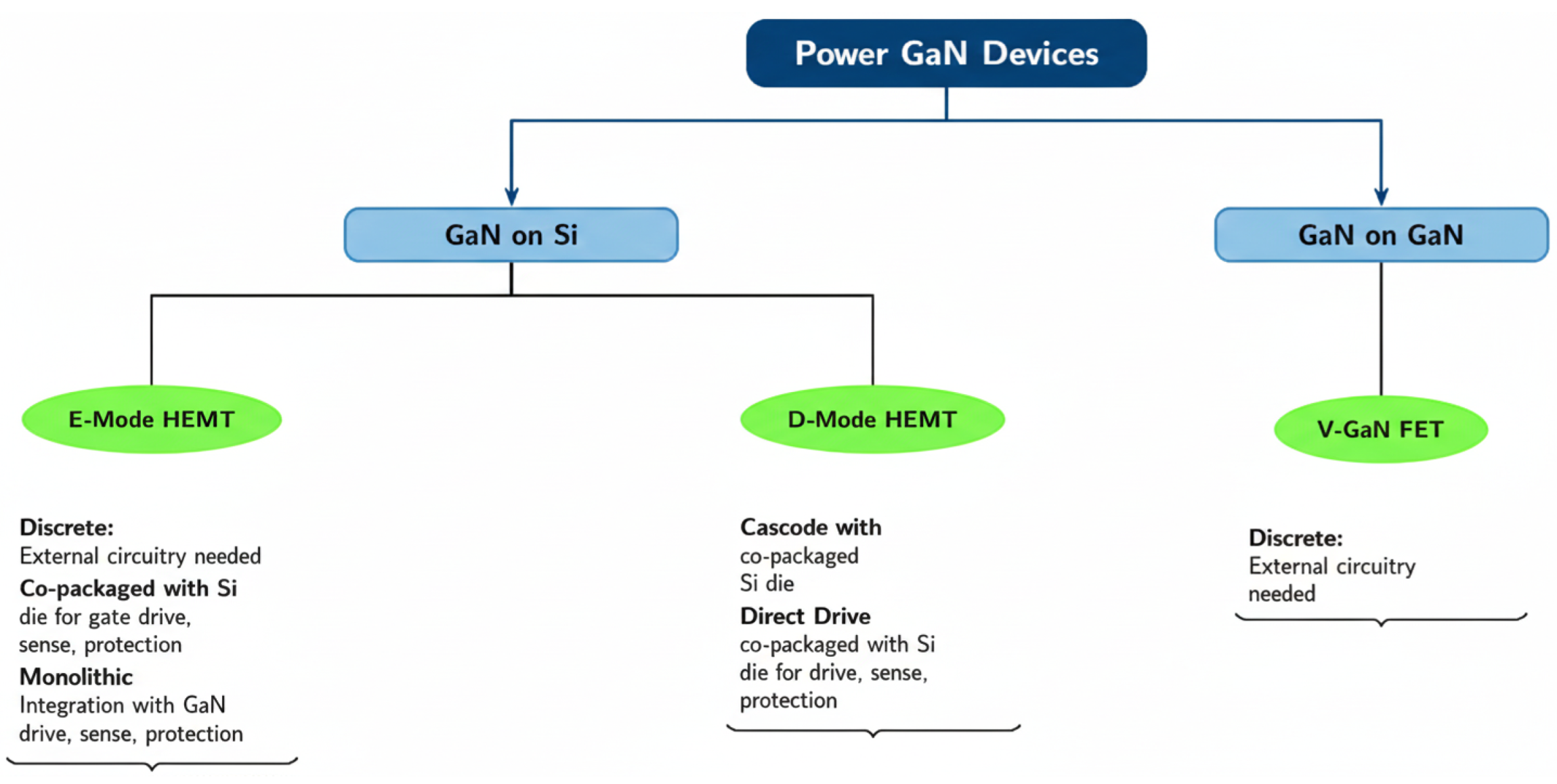
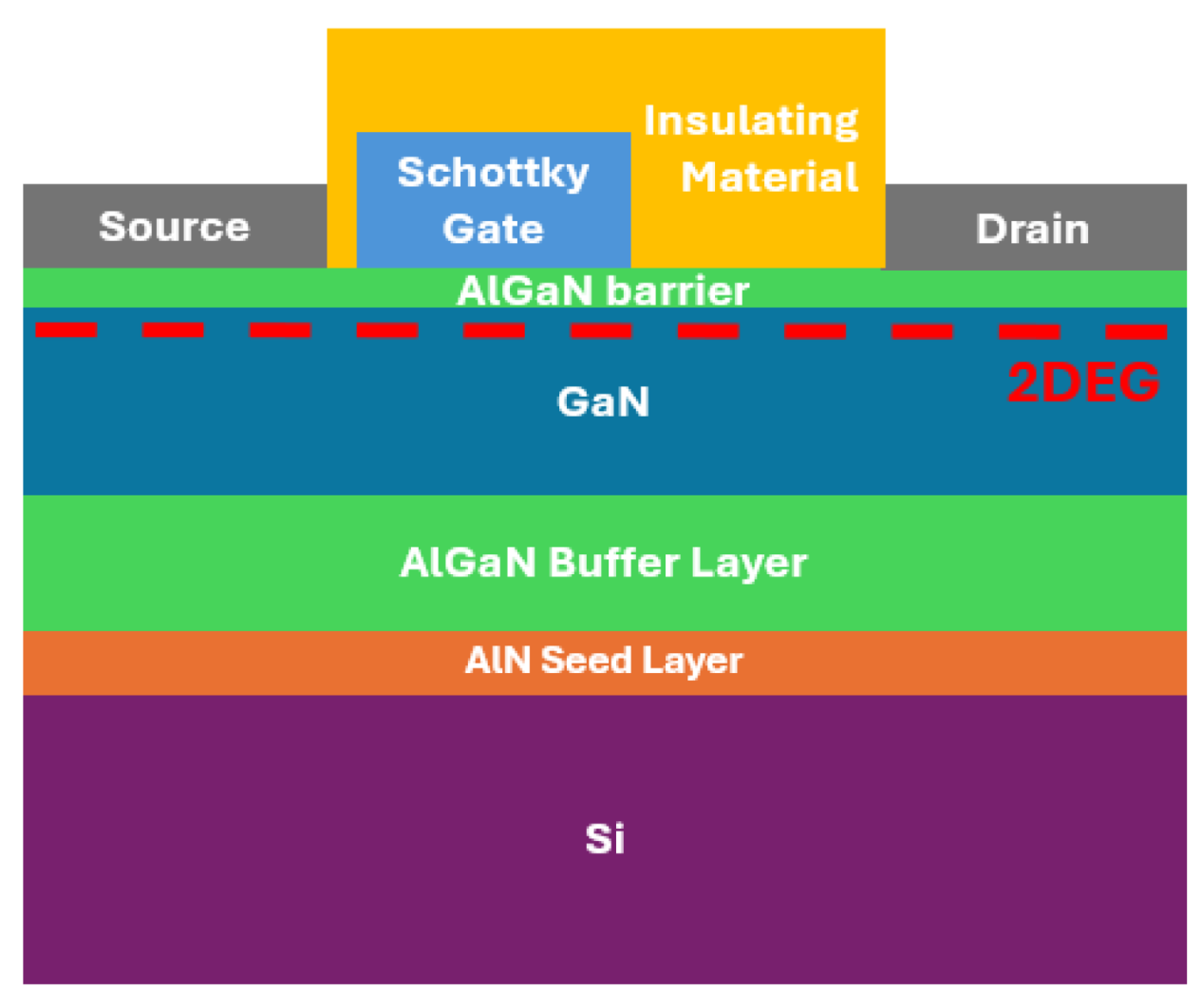
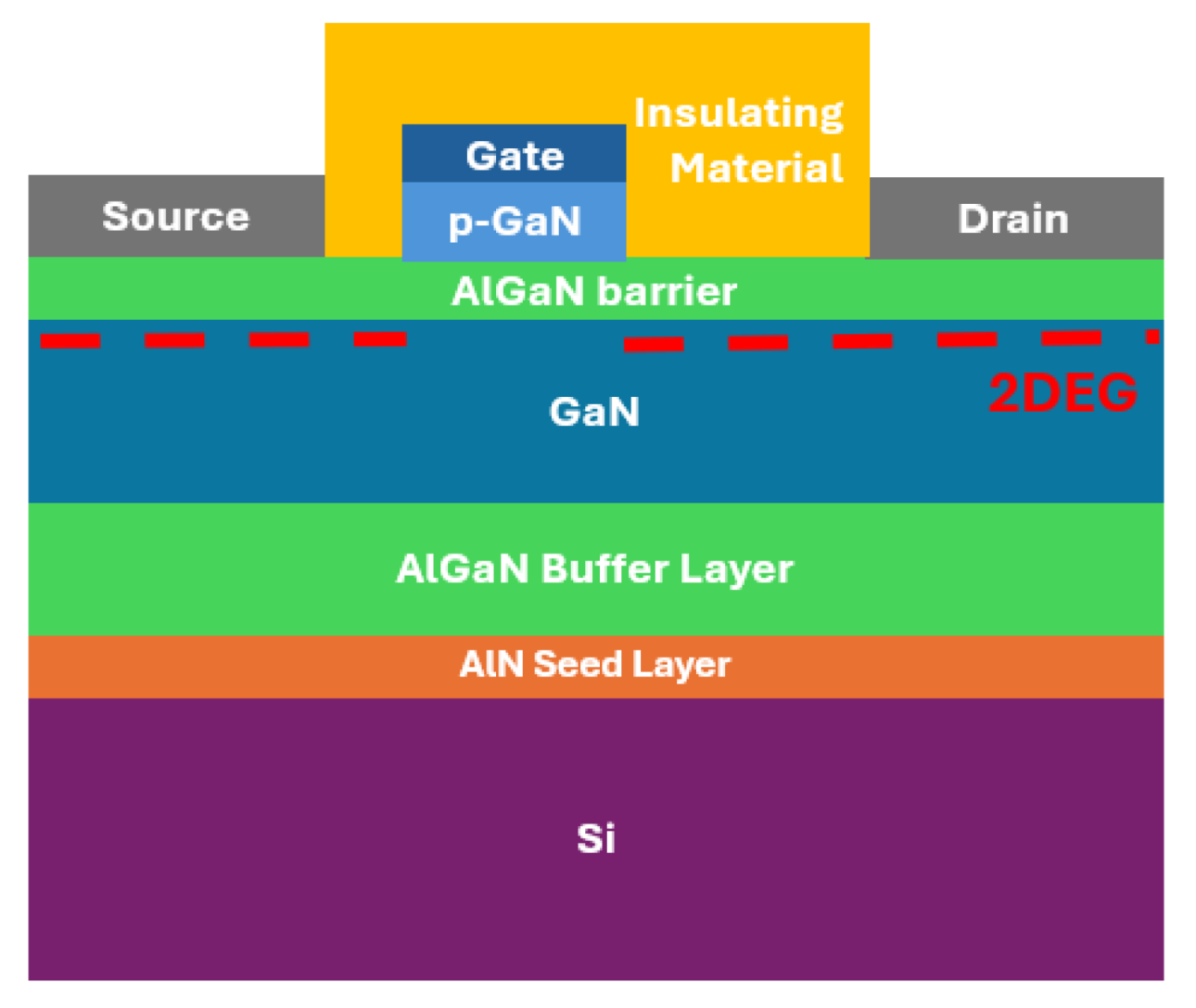
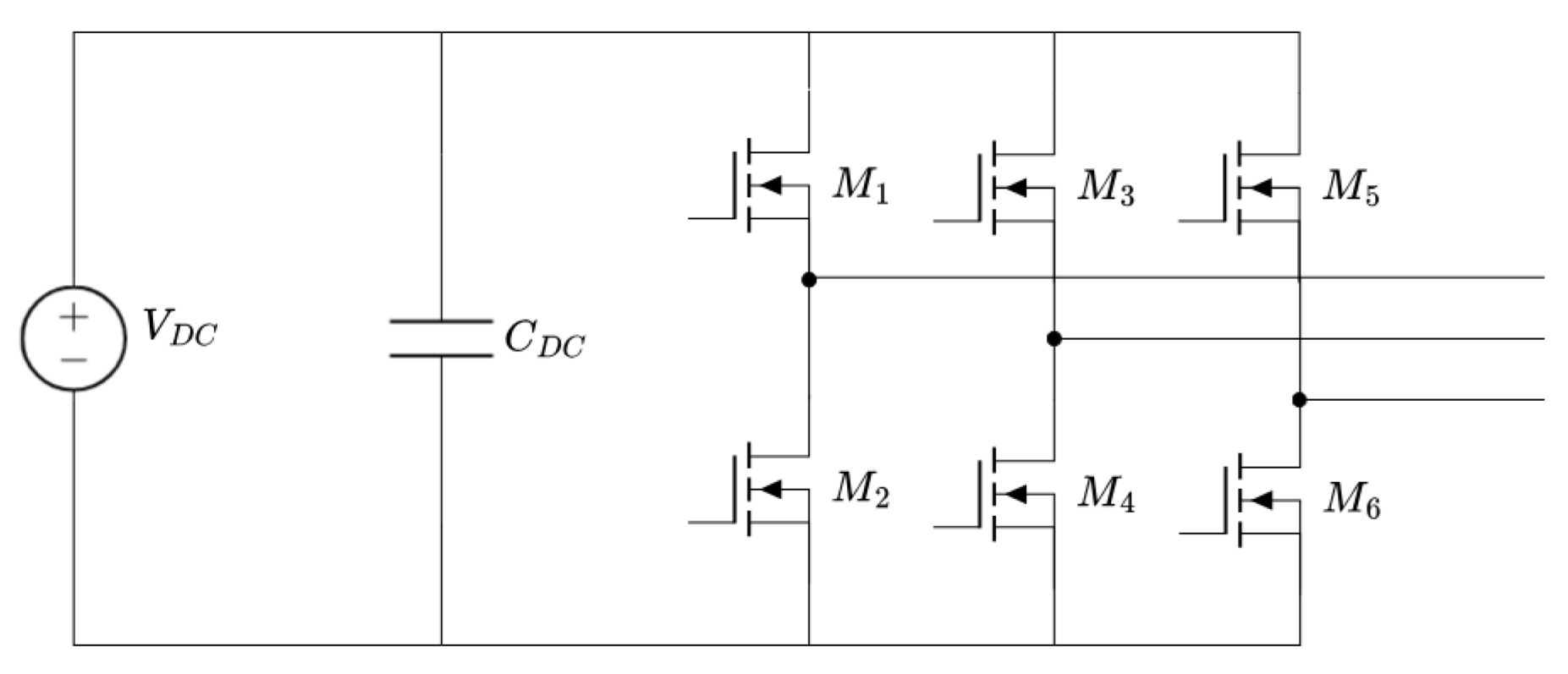
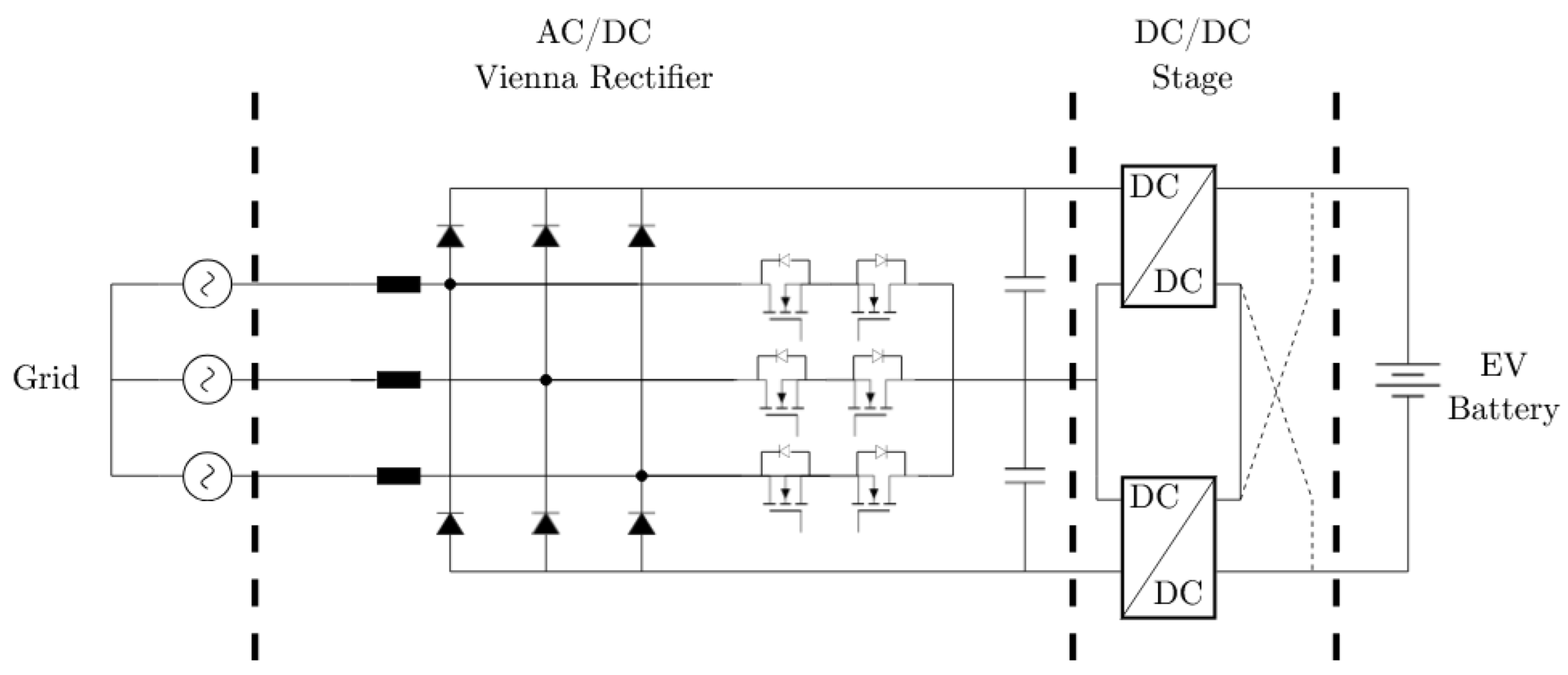
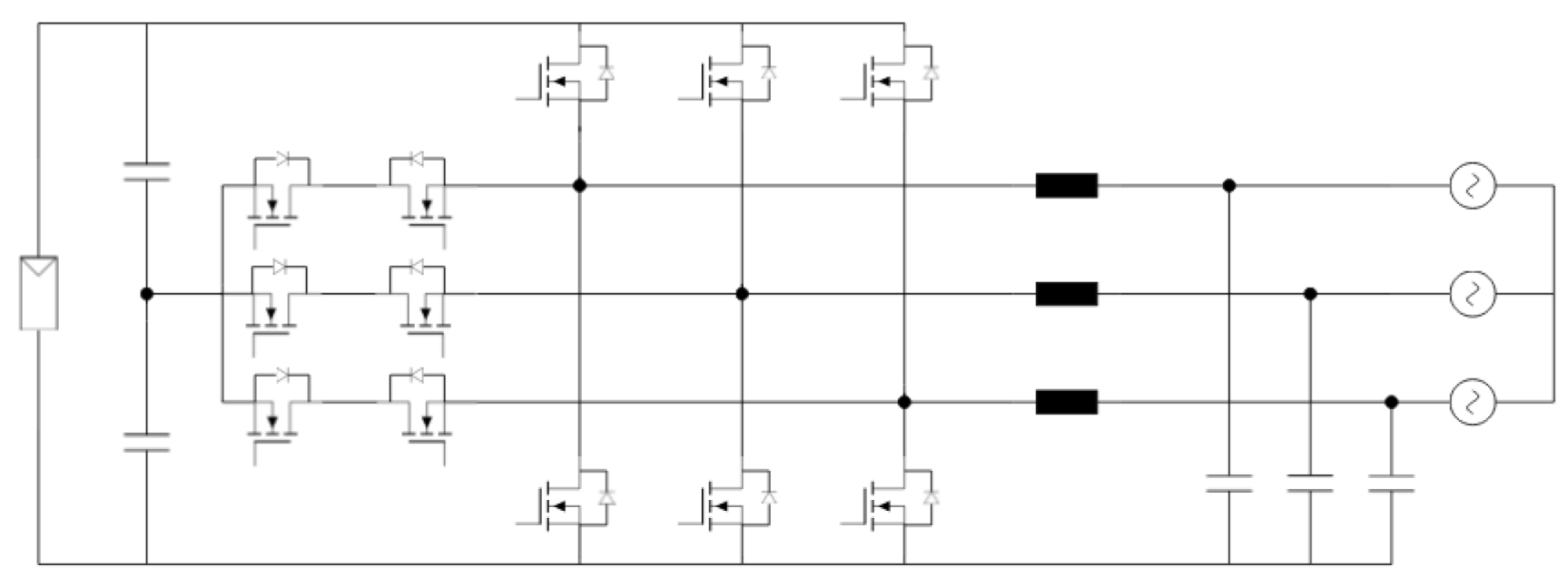
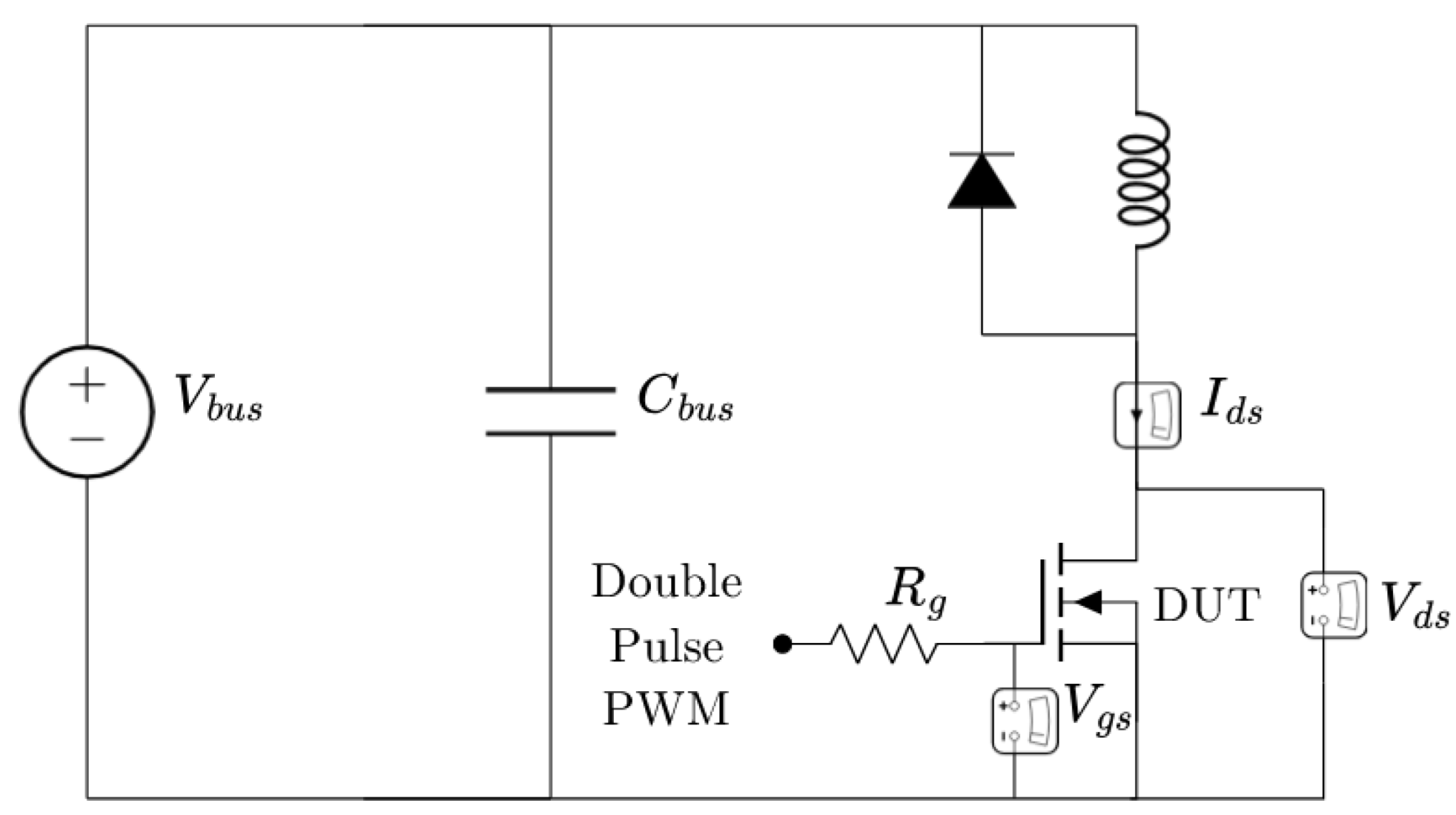
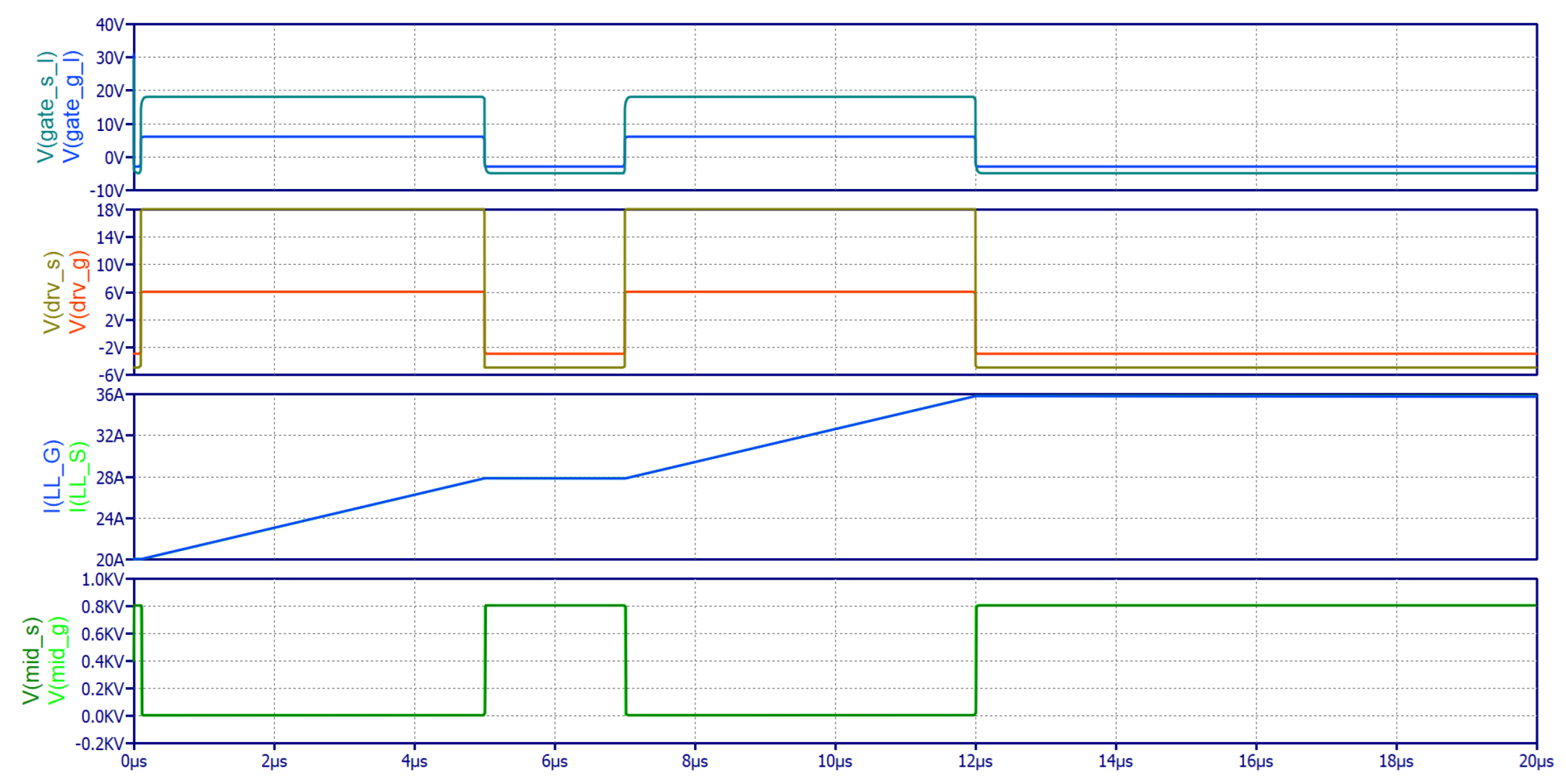
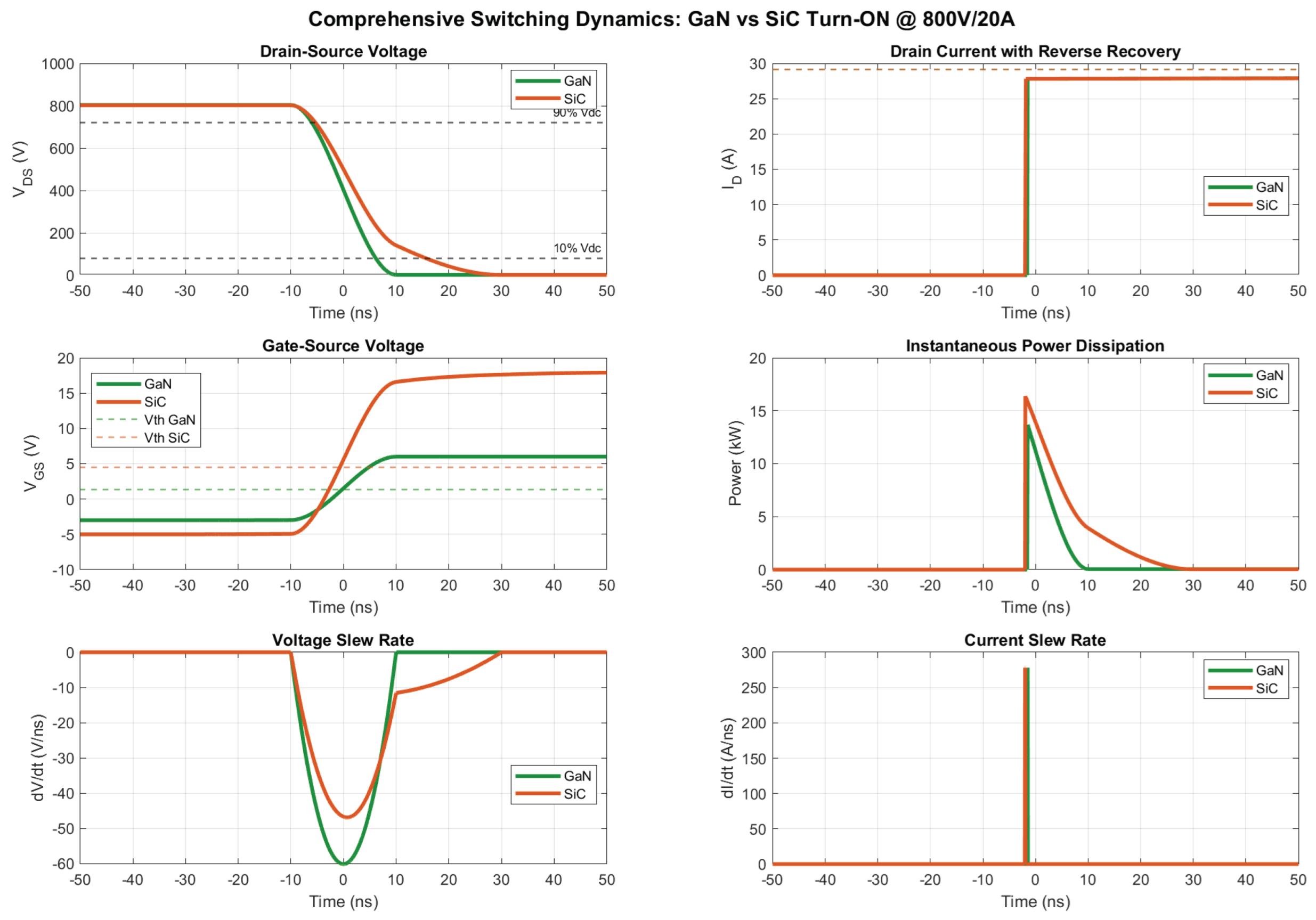
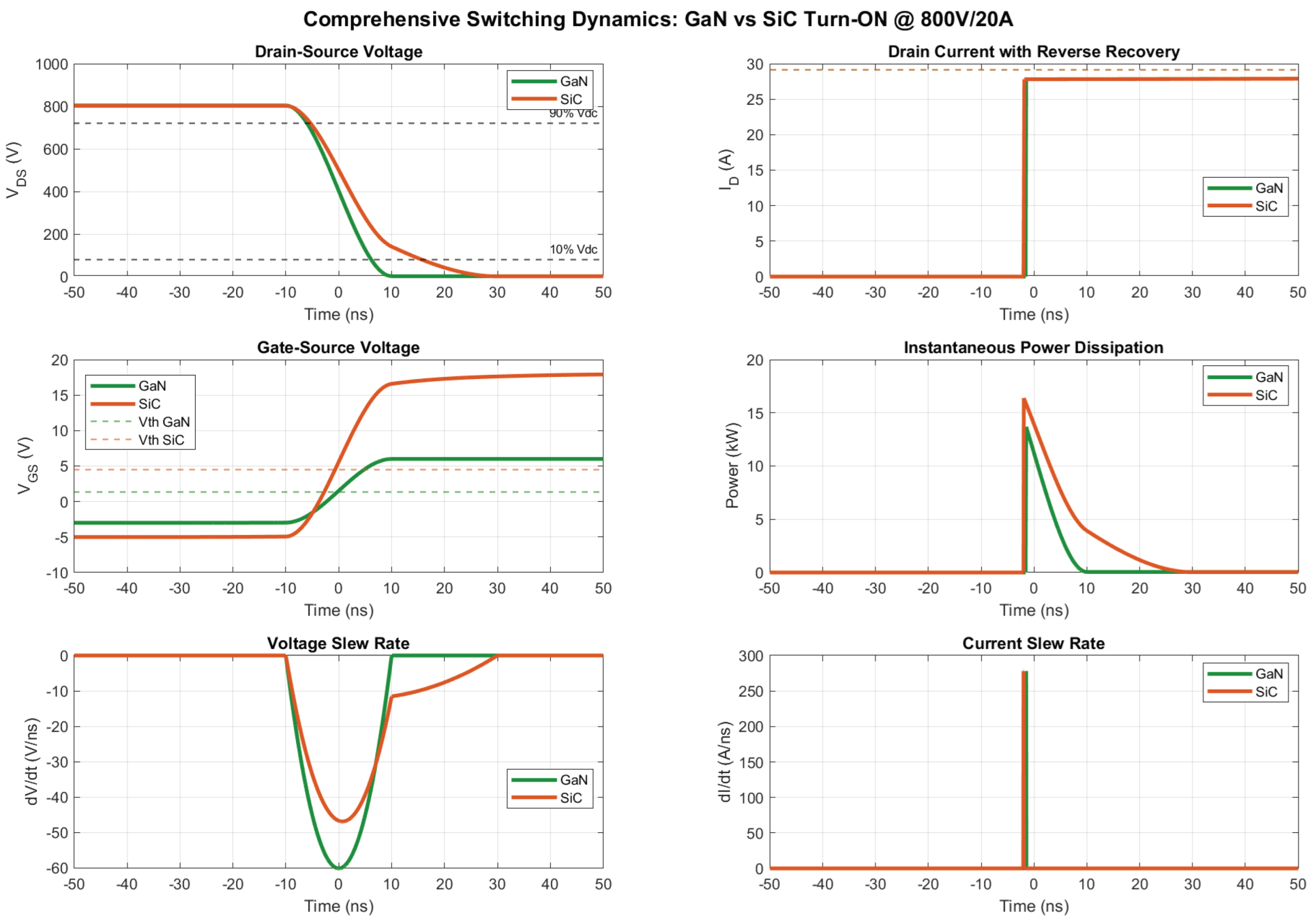

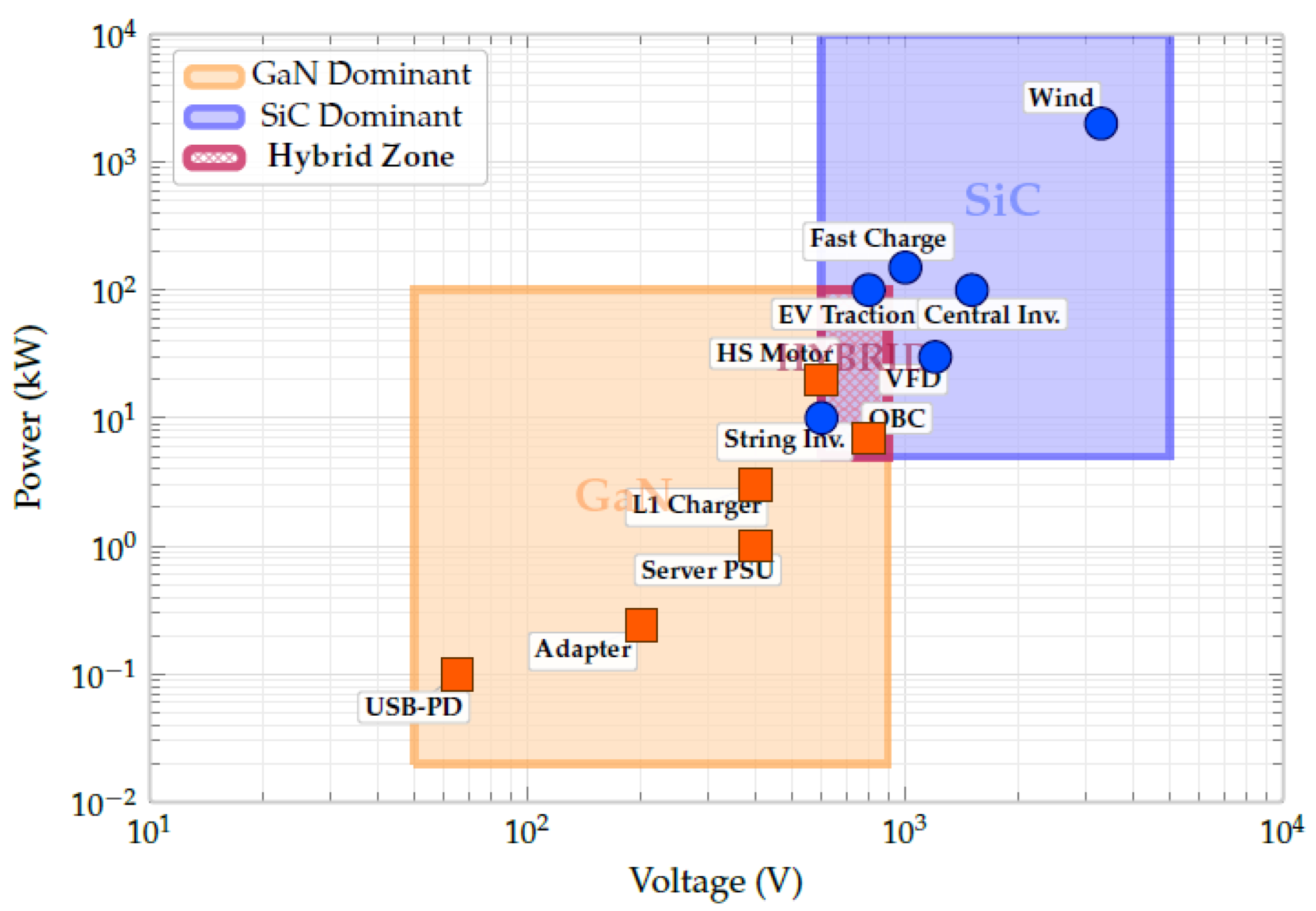
| Category | Papers Reviewed | Key Focus Areas |
|---|---|---|
| SiC Device Technology | 12 | MOSFET structures, trench devices, reliability, failure modes |
| GaN HEMT Technology | 13 | E-mode/D-mode, dynamic , trapping effects |
| Converter Topologies | 10 | DAB, Buck, Inverters, Magnetics, Wireless Power |
| System Applications | 14 | EV Traction, Hydrogen, Data Centers, Solar |
| UWBG Materials | 12 | Ga2O3, AlN, Diamond, c-BN, Heterostructures |
| EMI, Thermal & Pkg | 11 | Gate drivers, layout, thermal management, packaging |
| Emerging Technologies | 3 | Vertical GaN, Fin-JFETs |
| Fundamentals & Surveys | 3 | Figures of Merit, Methodology, Historical Trends |
| Total | 78 | — |
| Review Paper | Year | Scope | Strengths | Limitations |
|---|---|---|---|---|
| Buffolo et al. [8] | 2024 | Industrial SiC/GaN devices | Excellent reliability analysis; commercial device survey; trapping mechanisms | Limited topology comparison; no UWBG coverage; no economic analysis |
| Rafin et al. [14] | 2023 | WBG/UWBG overview | Broad material coverage; historical context; FOM analysis | Limited system-level analysis; no vertical GaN/BDS; no design guidelines |
| Chow et al. [15] | 2025 | Carbon neutrality focus | Sustainability perspective; policy implications; grid integration | Limited converter topology detail; no practical design constraints |
| Kumar et al. [16] | 2022 | Material properties | Comprehensive FOM analysis; device physics | Dated commercial landscape (2022); no emerging devices; limited applications |
| She et al. [17] | 2017 | SiC power devices | Deep SiC device analysis; HVDC applications; converter topologies | Pre-dates GaN maturation; no UWBG coverage; limited GaN comparison |
| Musumeci & Barba [18] | 2023 | GaN power devices | Comprehensive GaN focus; DC-DC and DC-AC applications | SiC comparison limited; no UWBG materials; no system-level KPIs |
| This Review | 2026 | System-level WBG/UWBG | See Added Value below | — |
| Contribution | New Data | New Insights | New Framework |
|---|---|---|---|
| Topology Comparison (Table 9) | 9 topologies compared: VSI, Buck, DAB, Vienna, T-type/NPC, LLC, Matrix, HERIC, CSI | First systematic SiC/GaN/vGaN/BDS device selection criteria with quantitative metrics | Decision guidelines based on voltage class, power level, and switching frequency |
| Emerging Devices (Sec. Section 5.3) | vGaN: 1.2 kV/50 A with 50% loss reduction vs. lateral GaN; BDS: 650–850 V monolithic four-quadrant operation | First converter-level vGaN/BDS impact analysis on 8 topologies (Table 8); commercialization timeline 2025–2030 | Technology selection: vGaN for 650 V–1.2 kV unidirectional; BDS for bidirectional/single-stage conversion |
| UWBG Materials (Sec. Section 3) | -Ga2O3: 4” wafers, 2.3 kV; AlN: 7.3 MV/cm; Diamond: 4.6 kV SBD; c-BN: 6.4 eV bandgap | TRL assessment (2–6); projected commercialization: -Ga2O3 2027–30, AlN/Diamond 2030–35, c-BN ≥2035 | Material-to-application mapping: -Ga2O3 for 600 V–3.3 kV, AlN for 10 kV+/RF, Diamond for extreme power |
| Bottom-Up Framework | 6 Figure of Merits analyzed: BFOM, BHFFOM, JFOM, KFOM, CHFFOM, TFOM (Table 5) | Clear traceability from material properties (, , , ) through device FOMs to system-level KPIs | 4-tier methodology: Materials → Devices → Converters → Systems; PRISMA-compliant review |
| Economic Analysis (Table 14) | 6 sectors: Data center ($450k/yr), EV (+20 km), Solar PV ($35k/yr), Industrial VFD ($22k/yr), Telecom ($8k/site), Aerospace (−15 kg) | Payback periods: 1.5 yr (data center), 2 yr (solar), 2.5 yr (industrial); immediate ROI for EV range and aerospace weight | Sector-specific efficiency gains: 94→97% (data center), 96→99% (EV traction), 92→95% (telecom) |
| Design Constraints (Sec. Section 10) | Dynamic : 2–5× degradation; instability; short-circuit withstand: GaN <1 s, SiC 2–5 s | 8 mitigation strategies: negative gate bias, active Miller clamping, desaturation detection (<200 ns), optimized buffer designs | Gate driver requirements matrix (Table 11): , , propagation delay, CMTI |
| Parameter | Si | 4H-SiC | GaN | -Ga2O3 | AlN | c-BN | Diamond |
|---|---|---|---|---|---|---|---|
| (eV) | 1.12 | 3.23 | 3.4 | 4.9 | 6.2 | 6.4 | 5.5 |
| (MV/cm) | 0.3 | 2.5 | 3.3 | 8 | 15 | 12 | 10 |
| (cm2/Vs) | 1440 | 950 | 2000 | 250 | 850 | 200 | 4500 |
| ( cm/s) | 1.0 | 2.0 | 2.4 | 1.1 | 1.4 | 2.0 | 2.3 |
| (W/cmK) | 1.5 | 3.7 | 2.5 | 0.1–0.3 | 2.85 | 13 | 23 |
| Material | BFOM | BHFFOM | JFOM | KFOM | CHFFOM | TFOM |
|---|---|---|---|---|---|---|
| Si | 1 | 1 | 1 | 1 | 1 | 1 |
| 4H-SiC | 317 | 13.7 | 20 | 4.8 | 29 | 3.3 |
| GaN | 846 | 27.5 | 33 | 1.4 | 56 | 2.2 |
| -Ga2O3 | 3444 | 10.5 | 14 | 0.9 | 30 | 0.8 |
| AlN | 3360 | 57.6 | 68 | 13.8 | 562 | 9.2 |
| Diamond | 50000 | 81.2 | 163 | 46.2 | 2114 | 33 |
| Parameter | -Ga2O3 | AlN | c-BN | Diamond |
|---|---|---|---|---|
| Wafer Size (Comm.) | 4-incha | 4-inch | N/A | 2-inch |
| Best Device | 2.3 kV | 2.2 kV | N/A | 4.6 kV |
| TRL Levelb | 5–6 | 3–4 | 2–3 | 3–4 |
| (eV) | 4.9 | 6.2 | 6.4 | 5.5 |
| (W/cmK) | 0.1–0.3 | 2.85 | 13 | 22–23 |
| Primary Challenge | Low | Doping/Contacts | Substrate size | n-type doping |
| Target Applications | 600V–3.3kV | 10kV+, RF | >10kV, extreme | Extreme power |
| Projected Commerc.c | 2027–2030 | 2030–2035 | ≥2035 | 2030–2035 |
| Parameter | GaN HEMT | GaN Cas. | SiC MOS | Si IGBT |
|---|---|---|---|---|
| Voltage (V) | 600–650 | 600–900 | 650–3300 | 600–6500 |
| Current (A) | 1–90 | 10–60 | 5–200 | 10–3600 |
| (mcm2) | 1–5 | 3–8 | 3–15 | — |
| Max (MHz) | 1–40 | 0.5–10 | 0.1–2 | 0.02–0.1 |
| (V/ns) | 50–200 | 30–100 | 20–100 | 1–20 |
| (nC) | 1–20 | 10–50 | 20–300 | 100–5000 |
| Max (°C) | 150–175 | 150 | 175–200 | 175 |
| Rev. Recovery | None | Limited | Moderate | V. High |
| FOM () | Best | Good | Good | Poor |
| Cost ($/A) | Medium | Med-High | High | Low |
| Topology | Current SiC Solution | Vertical GaN Potential | GaN BDS Potential | Timeline |
|---|---|---|---|---|
| Traction Inverter | 1.2 kV SiC MOSFET, 10–20 kHz | 1.2 kV vGaN, 50–100 kHz, 50% lower losses | Not applicable | vGaN: 2027–2029 |
| Vienna Rectifier | Back-to-back SiC, 30–50 kHz | Higher frequency, smaller magnetics | Single-device solution, 100 kHz+ | BDS: 2025–2026 |
| DAB Converter | SiC for >50 kW, ZVS operation | Smaller transformer, higher frequency | Single-stage capability | vGaN: 2028+ |
| T-Type Inverter | Discrete SiC neutral switches | Enhanced switching speed | 50% lower , simplified drive | BDS: Available now |
| Matrix Converter | Complex discrete arrays | N/A | Revolutionary: single-device BDS | BDS: 2025–2026 |
| HERIC (PV) | Discrete Si/SiC switches | N/A | MHz operation, grid support | BDS: Available now |
| CSI Motor Drive | SiC + series diodes | Native blocking, lower losses | Native bidirectional blocking | Both: 2027+ |
| Single-Stage OBC | Two-stage (PFC + DC-DC) | N/A | Eliminates DC-link capacitor | BDS: 2025–2026 |
| Topology | SiC Advantages | GaN Advantages | Recommended |
|---|---|---|---|
| Two-Level VSI | Higher voltage (1.2–3.3 kV), better thermal | Lower switching losses, smaller passives | SiC (>100 kW) |
| Buck (<1 kW) | Better thermal margin | 10× lower , MHz operation | GaN |
| Buck (>10 kW) | Higher current handling | Lower switching losses at 100–500 kHz | SiC |
| Interleaved | Better current sharing, thermal stability | Phase current cancellation, smaller magnetics | Application dependent |
| DAB (<20 kW) | Wide ZVS range | >500 kHz, smaller transformer | GaN |
| DAB (>50 kW) | 1.2 kV/>100 A devices | Lower turn-off losses | SiC |
| Vienna Rectifier | Higher voltage margin | Lower THD with higher | GaN (<30 kW); SiC (>30 kW) |
| T-Type/NPC | 1700 V devices for 1500 V PV | BDS enables single-package solution | GaN (resid.); SiC (utility) |
| LLC Resonant | Wide input range, stable | Very low , enables >1 MHz | GaN |
| Property | SiC (4H) | GaN | AlN |
|---|---|---|---|
| Thermal conductivity (W/mK) | 330–490 | 130–200 | 285–320 |
| Max. junction temperature (°C) | >200 | 150–175 | >200 |
| Bandgap (eV) | 3.26 | 3.4 | 6.2 |
| Thermal coeff. of | Strongly negative |
| Parameter | Si MOSFET/IGBT | SiC MOSFET | GaN HEMT |
|---|---|---|---|
| Turn-on | +10 to +15 V | +15 to +20 V | +5 to +6 V |
| Turn-off | 0 V | −3 to −5 V | 0 V |
| Gate Charge () | 50–500 nC | 20–100 nC | 1–10 nC |
| Peak Drive Current | 1–4 A | 4–10 A | 1–5 A |
| Propagation Delay | 50–200 ns | 20–50 ns | <20 ns |
| Immunity | 10–50 V/ns | 50–150 V/ns | 100–300 V/ns |
| Negative Bias Req. | Optional | Required | Not Required |
| Miller Plateau | Flat, defined | Higher, not flat | Low, fast |
| Range | 2–4 V | 1.5–4 V | 1–2 V |
| Sector | Application | Impr. | Savings | Payback |
|---|---|---|---|---|
| Data Center | Server PSU (10 MW) | 94→97% | $450k/yr | 1.5 yr |
| EV | Traction inverter | 96→99% | +20 km | Immed. |
| Solar PV | String inv. (1 MW) | 96→98.5% | $35k/yr | 2 yr |
| Industrial | Variable Frequency Drive (VFD) (500 kW) | 95→98% | $22k/yr | 2.5 yr |
| Telecom | 5G base station | 92→95% | $8k/site | 1.8 yr |
| Aerospace | Aux. power unit | 93→97% | −15 kg | Immed. |
| KPI | Silicon | WBG |
|---|---|---|
| Peak efficiency () | 94–97% | 98–99.5% |
| Power density | 3–8 kW/L | 15–50 kW/L |
| Specific power | 2–5 kW/kg | 8–20 kW/kg |
| Switching frequency () | 20–100 kHz | 0.2–2 MHz |
| Maximum junction temp. () | 150°C | 175–200°C |
| Total harmonic distortion (THD) | 3–8% | 1–3% |
| Voltage slew rate () | 5–15 kV/s | 50–200 kV/s |
| Current slew rate () | 1–5 kA/s | 10–50 kA/s |
| Parameter | Si IGBT (8 kHz) | SiC MOSFET (100 kHz) |
|---|---|---|
| Switching losses | 180 W | 45 W |
| Gate drive power | 0.8 W | 4.2 W |
| EMI filter volume | 1.2 L | 0.4 L |
| EMI filter cost | $45 | $120 |
| PCB layer count | 4 | 6 |
| Motor dv/dt stress | 2.5 kV/s | 15–25 kV/s |
| Design Aspect | Conventional | GaN 500 kHz |
|---|---|---|
| Layer count | 4 | 6 |
| Copper weight (inner) | 1 oz | 2 oz |
| Via technology | Standard | Filled/capped |
| Impedance control | No | Yes |
| PCB cost per unit | $12 | $38 |
| OEM | Model | Tech | Application | Perf. Gain | Year |
|---|---|---|---|---|---|
| Tesla | Model 3/Y | SiC | Traction Inverter | +8% range | 2017 |
| BYD | Han EV | SiC | Traction + OBC | +5% efficiency | 2020 |
| Lucid | Air | SiC | 900V Inverter | +10% range | 2021 |
| Hyundai | IONIQ 5 | SiC | 800V Charging | 18 min charge | 2021 |
| Mercedes | EQS | SiC | Traction Inverter | +6% range | 2022 |
| BMW | iX | GaN | OBC | 40% size red. | 2022 |
| Porsche | Taycan | SiC | 800V System | 270kW charge | 2019 |
| VW | ID.7 | SiC | APP310 Inv. | +5% efficiency | 2023 |
| Package | (nH) | (nH) | (pF) | Max Range |
|---|---|---|---|---|
| TO-247 | 10–15 | 5–10 | 5–10 | <100 kHz |
| D2PAK | 5–8 | 3–5 | 3–5 | <500 kHz |
| SMD (GaN) | 0.5–2 | 1–3 | 1–2 | >1 MHz |
| Chip-scale | 0.1–0.5 | 0.5–1 | 0.5–1 | >5 MHz |
| DFN (QFN) | 1–3 | 2–4 | 2–3 | 200–800 kHz |
| LGA | 0.3–1 | 0.8–2 | 1–2 | 1–3 MHz |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2026 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).




